在缺少EUV光刻机的情况下,国内半导体行业需要依赖DUV实现更先进的工艺,技术挑战极大,台积电、Intel只用到了7nm节点,国内则要挑战3nm及以下工艺。
DUV生产3nm工艺面临的一个瓶颈问题就是精度控制,南京激埃特光电日前发文提到国内某机构在DUV光学系统升级时就遇到了这个挑战,照明系统均匀性不足导致晶圆曝光线宽一致性偏差超过±2nm,无法满足3nm节点的工艺要求。
该公司介绍了他们的解决方案,其光学镀膜团队设计了多层介质硬膜方案:
膜层结构:采用SiO₂和Ta₂O₅交替沉积,总层数40-60层;
工艺参数:离子辅助沉积(IAD)技术,基底温度250℃,本底压强2×10⁻⁵Pa;
关键指标:中心波长193±0.2nm,峰值透过率>92%,截止深度OD6(带外透过率<10⁻⁶)。
最终结果如何呢,他们公布的数据如下:
曝光质量提升:晶圆片内线宽均匀性从±2.1nm改善至±0.8nm,良率预估提升5-8%;
对准精度提高:对准系统定位精度从±1.5nm提升至±0.8nm;
系统稳定性增强:连续工作100小时后,光路漂移量减少70%。

这一方案也得到了客户团队的认可,表示激埃特的技术方案不仅解决了照明均匀性问题,其滤光片的带外抑制能力更将系统整体信噪比提升了3倍,特别是微透镜阵列的面形精度控制,达到了我们之前未能实现的λ/10水平,为后续工艺迭代预留了充足的技术余量。

对于这一技术如何看待呢?激埃特光电的光学镀膜技术将DUV光学系统的线宽均匀性从2.1nm提升到0.8nm,同时对准系统精度也从1.5nm提升到了0.8nm,这对DUV量产先进制程芯片无疑很重要,因为精度不行,生产的芯片是废的,尤其是DUV本身制造5nm到3nm芯片都是极难的。
不过这里的精度还不是光刻机的Overlay套刻精度,如果是套刻精度0.8nm,那比EUV光刻机都要牛了,但这个进展也值得庆贺,意味着国内的厂商在用DUV搞定3nm工艺芯片已经到了一定程度,即便还没量产,但打通流程还是有戏的。
这个技术放在全球来看也是独一无二的,因为台积电、三星及Intel在5nm甚至7nm节点就全面启用EUV光刻了,他们也没有这样的研发经验。
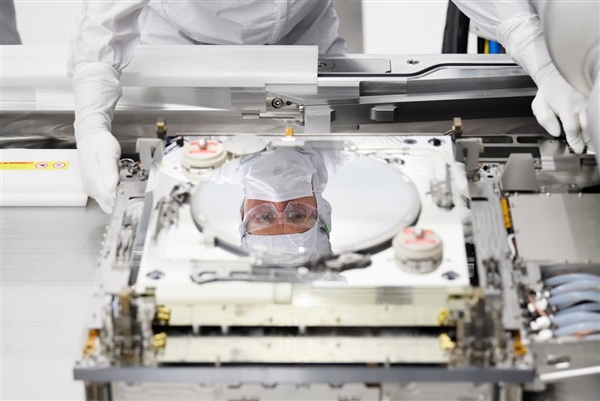
|
||||||||||||
|
||||||||||||



